铝碳化硅AlSiC (有的文献英文缩略语写为SiCp/ Al或Al/SiC、SiC/Al)是一种颗粒增强金属基复合材料,采用Al合金作基体,按设计要求,以一定形式、比例和分布状态,用SiC颗粒作增强体,构成有明显界面的多组相复合材料,兼具单一金属不具备的综合优越性能。AlSiC研发较早,理论描述较为完善, 有品种率先实现电子封装材料的规模产业化,满足半导体芯片集成度沿摩尔定律提高导致芯片发热量急剧升高、使用寿命下降以及电子封装的“轻薄微小”的发展需求。尤其在航空航天、微波集成电路、功率模块、军用射频系统芯片等封装方面作用极为凸现,成 为封装材料应用开发的重要趋势。
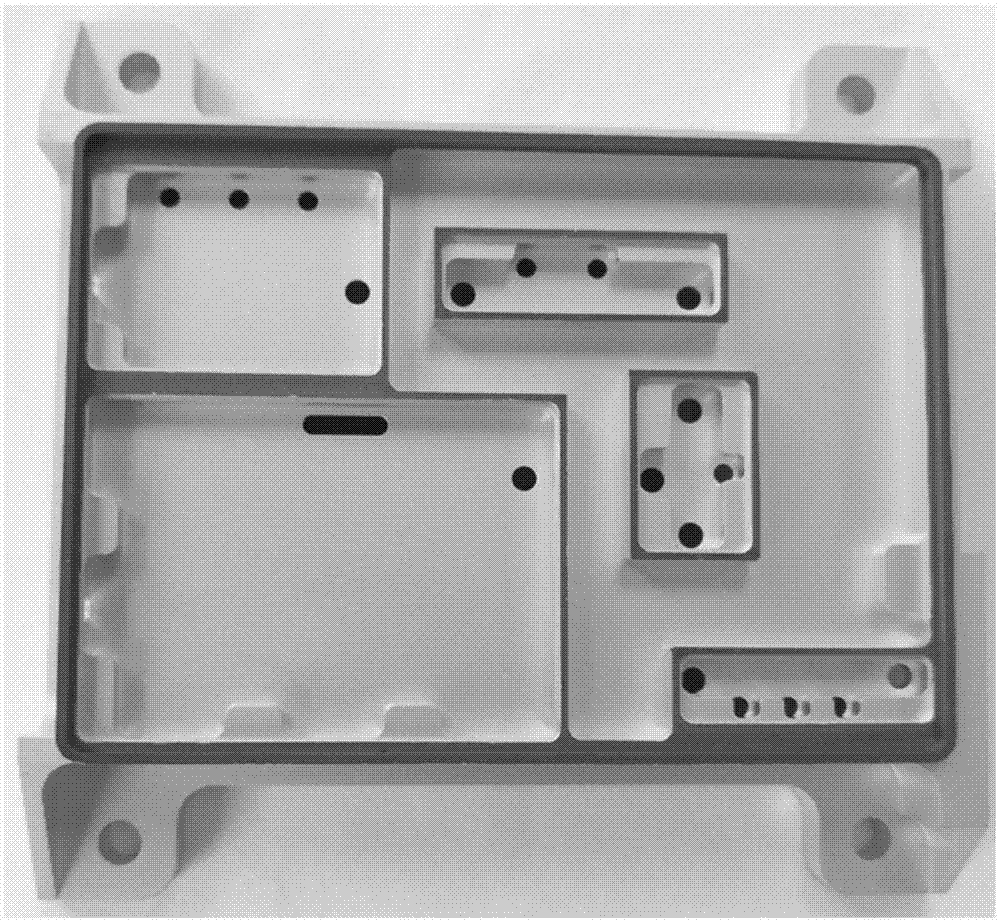
1、封装AlSiC特性
封装金属材料用作支撑和保护半导体芯片的金属 底座与外壳,混合集成电路HIC的基片、底板、外 壳,构成导热性能最好,总耗散功率提高到数十瓦, 全气密封性,坚固牢靠的封装结构,为芯片、HIC提 供一个高可靠稳定的工作环境,具体材料性能是个首 选关键问题。常用于封装的电子金属材料的主要特性 如表1所示。
在长期使用中,许多封装尺寸、外形都已标准 化、系列化,存在的主要缺陷是无法适应高性能芯片 封装要求。例如,Kovar ( 一种Fe-Co-Vi合金)和Invar (一种Fe-Ni合金)的CTE低,与芯片材料相近, 但其K值差、密度高、刚度低,无法全面满足电子 封装小型化、高密度、热量易散发的应用需求。合金 是由两种或两种以上的金属元素或金属与非金属元素 所组成的金属材料,具有其综合的优势性能。随之发 展的 M080 Cu20、Cu/ Invar/Cu、Cu/ Mo/Cu 等合金 在热传导方面优于Kovar,但其比重大于Kovar,仍不适合用作航空航天所需轻质的器件封装材料。
常用金属封装材料与CaAs芯片的微波器件封装 需求存在性能上的差距,使得研发一种新型轻质金属 封装材料,满足航空航天用器件封装成为急需,引发 相关部门调试重视。经过近些年来的深入研究,AlSiC 取得产业化进展,相继推动高硅铝合金Si/Al实用化 进程,表2示出其主要性能与常用封装材料的对比。将SiC与Al合金按一定比例和工艺结合成AlSiC后,可克服目前金属封装材料的不足,获得高K值、低 CTE、高强度、低密度导电性好的封装材料。
从产业化趋势看,AlSiC可实现低成本的、无需进一步加工的净成形(net-shape )或需少量加工的近净成形制造,还能与高散热材料(金刚石、高热传导石墨等)的经济性并存集成,满足大批量倒装芯片封 装、微波电路模块、光电封装所需材料的热稳定性及散温度均匀性要求,同时也是大功率晶体管、绝缘栅双极晶体管的优选封装材料,提供良好的热循环及可靠性。
2、封装AlSiC类型
封装金属基复合材料的增强体有数种,SiC是其中应用最为广泛的一种,这是因为它具有优良的热性能,用作颗粒磨料技术成熟,价格相对较低;另一方 面,颗粒增强体材料具有各向同性,最有利于实现净 成形。AlSiC特性主要取决于SiC的体积分数(含量) 及分布和粒度大小,以及Al合金成分。依据两相比例或复合材料的热处理状态,可对材料热物理与力学性能进行设计,从而满足芯片封装多方面的性能要求。其中,SiC体积分数尤为重要,实际应用时,AlSiC与 芯片或陶瓷基体直接接触,要求CTE尽可能匹配,为 此SiC体积百分数vol通常为50%?75%,表3示出某厂家产业化净成形AlSiC级别的详细情况。
此外,AlSiC可将多种电子封装材料并存集成, 用作封装整体化,发展其他功能及用途。研制成功将高性能、散热快的Cu基封装材料块(Cu-金刚石、Cu-石墨、Cu-BeO等)嵌人SiC预制件中,通过金属Al 熔渗制作并存集成的封装基片。在AlSiC并存集成过程中,可在最需要的部位设置这些昂贵的快速散热材料,降低成本,扩大生产规模,嵌有快速散热材料的AlSiC倒装片系统正在接受测试和评估。另外,还可并存集成48号合金、Kovar和不锈钢等材料,此类材料或插件、引线、密封环、基片等,在熔渗之前插入SiC预成形件内,在AlSiC复合成形过程中,经济地完成并存集成,方便光电器件封装的激光连接。
采用喷射沉积技术,制备了内部组织均匀、性能优良、Si含量髙达70wt% (重量百分率)的高硅铝合金SiAl封装材料,高硅铝合金CE牌号的性能如表4所示,由于其CTE与Si、GaAs较匹配,也可用于射频、微波电路的封装及航空航天电子系统中,发 展为一种轻质金属封装材料。

3、封装AlSiC制备
SiC颗粒与Al有良好的界面接合强度,复合后 的CTE随SiC含量的变化可在一定范围内进行调节, 由此决定了产品的竞争力,相继开发出多种制备方 法。用于封装AlSiC的预制件的SiC颗粒大小多在1 um-80um范围选择,要求具有低密度、低CTE、 高弹性模量等特点,其热导率因纯度和制作制作方法 的差异在80W ( m . K ) -200W ( m . K )之间 变化。基体是强度的主要承载体,一般选用6061、 6063、2124、A356等高强度Al合金,与SiC按 一定比例和不同工艺结合成AlSiC,解决SiC与Al 润湿性差,高SiC含量难于机加工成形等问题,成为 理想的封装材料。
制备50vol% ~ 75vol% SiC高含量的封装用AlSiC 多采用熔渗法,其实质是粉末冶金法的延伸。它通 过先制备一定密度、强度的多孔基体预制件,再渗以 熔点比其低的金属填充预制件,其理论基础是在金属 液润湿多孔基体时,在毛细管力作用下,金属液会沿 颗粒间隙流动填充多孔预制作孔隙,脱模无需机械加 工,在其表面上覆盖有一层0.13mm?0.25nm厚的完 美Al合金层,按用途电镀上Ni、Au、Cd、Ag, 供封装用。
熔渗法是AlSiC制备的关键,一般分为有压力渗 透和无压力渗透,前者根据生产过程中压力施加的大 小、方式的不同,又分为挤压熔渗、气压压力熔渗、离 心熔渗铸造法等,主要特点是需要真空和高压设备,渗 透时间较短,有效控制Al与SiC的界面反应,同时与 精度的模具相配套,获得实用性发展。后者是将Al合 金锭放置在SiC预制件上,在合金熔点以上保温,Al 合金液依托毛细管力的作用自发渗入预制件中,所需 设备简单,易于低成本制备,但产品的机械性能与热 性能略低,对基体合金的成分有较为严格的要求,浸 透需要在保护气氛中进行。粉末冶金法对SiC体积分数可在15% ~ 75%之间调节,SiC承载量大,但较难 实现材料的一次成形。
AlSiC封装材料产业化引起国内科研院所、大学等单位的广泛重视,积极着手研发其净成形工艺,部 分单位研制成功样品,为AlSiC工业化生产积累经验, 离规模化生产尚有一定距离,存在成本高、SiC体积含 量不高、低粘度、55% ~ 75%高体积分架料的制备与 浆粒原位固化技术等问题。
4、封装AlSiC的应用
IC产业的发展与其设计、测试、流片、封装等 各环节密切相联,最终在市场应用中体现价值认同,良 性循环形成量产规模,实现经济效益。封装技术至关 重要,尤其是军用产品一致采用金属封装、陶瓷封装 结构,确保器件、模块、组件、系统的整体可靠性。金 属封装气密性高,散热性好,形状可多样化,有圆形、 菱形、扁平形、浅腔与深腔形等,其材料难以满足当 今航空航天、舰船、雷达、电子战、精确打击、天基和 海基系统对大功率、微波器件封装的需求。按目前 VLSI电路功耗的同一方法计算,未来的SoC芯片将达到太阳表面温度,现有的设计和封装方法已不能满 足功率SoC系统的需求。AlSiC恰好首先在这一领域 发挥作用,现以军用为主,进而推向其他市场。
4.1 T/R模块封装
机载雷达天线安装在飞机万向支架上,采用机电 方式扫描,其发展的重要转折点是从美国F-22开始应 用有源电子扫描相控阵天线AESA体制,其探测距离 如表5所示,研发出多种AESA系统。例如,APG-80捷变波束雷达、多功能机头相控阵一体化航电系 统、多功能综合射频系统、综合式射频传感器系统、JSF 传感器系统等,所用T/R (发/收)模块封装技术日趋成熟,每个T/R模块成本由研发初期的10万美元降 至600-800美元,数年内可降至约200美元,成为机 载雷达的核心部分。几乎所有的美国参战飞机都有安 装新的或更新AESA计划,使其作战效能进一步发 挥,在多目标威胁环境中先敌发现、发射、杀伤,F-22 机载AESA雷达可同时探测跟踪目标数分别为空中30 个、地面16个、探测范围为360°全周向。

AESA由数以千计的T/R模块(有的高达9 000 个左右)构成,在每个T/R模块内部都有用GaAs 技术制作的功率发射放大器、低噪声接收放大器、T/ R开关、多功能增益/相位控制等电路芯片,最终 生产关键在其封装技术上,因机载对其体积与重量的 限制极为苛刻。AlSiC集低热胀、高导热、轻质于 一体,采用AlSiC外壳封装T/R模块,包括S、C、 X、Ku波段产品,可满足实用需求。雷达APG-77 是一部典型多功能、多工作方式雷达,其AESA直 径约1m,用2 000个T/R模块构成,每个T/R模块 输出功率10W,移相器6位,接收噪声系数2.9dB, 体积6.4cm3,重14.88g,平均故障间隔MTBF20万 h,其发射功率比初期产品增加16倍,接收噪声系 数降低1倍,体积重量减少83%,成本下降82%。 以1 000个T/R模块构成机载AESA雷达为例,用 AlSiC替代Kovar,雷达重量可减轻34kg,而热导 率比Kovar提高10余倍,且提高整机可靠性MTBF 达2 OOOh以上。试验表明,即使AESA中10%的T/R模块产生故障,对系统无显著影响,30%失效 时,仍可维持基本工作性能,具有所谓的“完美降级” 能力。
本世纪初,美国AlSiC年产量超过100万件,T/ R模块由“砖”式封装向很薄、边长5cm或更小方 块形的“瓦”式封装发展,进一步降低T/R模块的尺 寸、厚度、重量以及所产生的热量。欧洲防务公司、法、 英、德联合开发机载AESA及T/R模块技术,研制具 有1200个T/R模块全尺寸样机的试验工作,俄罗斯 积极着手研制第4代战斗机用AESA雷达,以色列、 瑞典研制出轻型机载AESA预警雷达,机载AESA及 T/R模块市场持续升温。
在国内,随着AESA产品的定型,T/R模块出现 批量生产需求,其基板、壳体的生产极为关键,采 用近净成形技术,研制出小批量T/R模块封装外壳样 品。用无压溶渗AlSiC制作基座替代W-Cu基座,封 装微波功率器件,按GJB33A-97和GJB128A-97军标 严格考核,器件的微波性能、热性能无变化,可完全满足应用要求,前者的重量只及W-Cu基座的 20%,且成本仅为后者的1/3左右,有望在封装领域大量替代W-Cu、Mo-Cu等材料。国产L波段功率器件月批量生产累计上千只,实现某型号雷达全面国产化、固态化,今后几年会持续批量生产,S、C波段功率模块怎样低成本生产,将涉及AlSiC封装材料的研发应用。
4.2倒装芯片封装
倒装芯片封装FCP技术优势在于能大幅度提高产 品的电性能、散热效能,适合高引脚数、高速、多功 能的器件。AlSiC的CTE能够与介电衬底、焊球阵列、 低温烧结陶瓷以及印刷电路板相匹配,同时还具有髙 热传导率、高强度和硬度,是倒装焊盖板的理想材料, 为芯片提供高可靠保护。AlSiC可制作出复杂的外形, 例如,AlSiC外壳产品有多个空腔,可容纳多块芯片, 用于提供器件连接支柱、填充材料的孔以及不同的凸 缘设计。AlSiC外形表面支持不同的标识和表面处理方 法,包括激光打印、油漆、油墨、丝网印刷、电镀,完 全满足FCP工艺要求。
4.3功率器件封装
大功率密度封装中管芯所产生的热量主要通过基 板材料传导到外壳而散发出去,上世纪九十年代中期, AlSiC巳用作功率放大器的基板,通过修改金属Al和 SiC颗粒的比例,来匹配裸芯片或衬底的CTE值,从 而防止空洞或剥离失效。事实表明,AlSiC基板对于Cu 基板系统有很好的可靠性,耐受成千上万次热循环也 不会失效,而Cu的可靠性达不到1000次热循环,这 从根本上解决功率器件散热问题,成为重要的功率器 件封装材料。
宽禁带半导体SiC、GaN在芯片制造中的应用显 示出很强的竞争优势,已制作高纯度100mm~150mm 的GaN圆片,在单位面积上可产生比其他器件高6倍 的功率,带宽达到1GHz~40GHz。功率半导体和集成 功率模块技术方兴未艾,AlSiC封装材料大有发展前景。
4.4光电封装
AlSiC可制作出光电模块封装要求光学对准非常 关键的复杂几何图形,精确控制图形尺寸,关键的 光学对准部分无需额外的加工,保证光电器件的对 接,降低成本。此外,AlSiC有优良的散热性能, 能保持温度均匀性,并优化冷却器性能,改善光电器件的热管理。
5、结束语
AlSiC金属基复合材料正成为电子封装所需高K 以及可调的低CTE、低密度、高强度与硬度的理想 材料,为各种微波和微电子以及功率器件、光电器件 的封装与组装提供所需的热管理,可望替代分别以 Kovar和W-Cu、Mo-Cu为代表的第一、第二代专 用电子封装合金,尤其在航空航天、军用电子器件的 封装方面需求迫切。一位老将军在自己的回忆录里写 道:“从海湾战争看,电子装备建设是我军作战的薄 弱环节,急需加强。”世界新军事变革出现加速发展 的趋势,信息化战争离不开整个芯片及封装产业的支 撑,若基础不牢,将会地动山摇。